لیتوگرافی یک تکنولوژی بسیار پیشرفته در صنعت نیمهرسانا و تراشهسازی محسوب میشود که در ادامه توضیح خواهیم داد که این فناوری چیست و چگونه توسعه پیدا میکند.
فوتولیتوگرافی یک فرآیند الگوگذاری حیاتی در تولید تراشهها است که شامل انتقال یک الگو از فوتوماسک به زیرلایه یا ویفر میشود. فرآیند فوتولیتوگرافی اصولا با استفاده از دستگاههای استپر و اسکنرهایی که بهمنابع نوری اپتیکی مجهز هستند، انجام میشود. علاوهبر فوتولیتوگرافی، روشهای دیگری مانند نوشتن مستقیم با پرتو الکترونی (e-beam) و نانوایمپرینت نیز وجود دارند؛ در ادامه به موضوع لیتوگرافی چیست و چهکاربردی دارد میپردازیم.
درحالحاضر، چندین فناوری لیتوگرافی نسل آینده (NGL) درحال تحقیق و توسعه هستند که از جمله آنها میتوان به لیتوگرافی با اشعه فرابنفش شدید (EUV)، پرتو الکترونی چندگانه (multi-beam e-beam) و مونتاژ خودهدایتشده (DSA) اشاره کرد.
باتوجهبه اینکه قانون مور نقشهراه فناوری نیمههادیها را به زیر یک میکرومتر هدایت کرده، به موازات آن به استفاده از فناوریهای نوین و پیشرفته برای تولید تراشههای پیشرفته نیاز مبرم است. در بیشتر مراحل این نقشهراه، راهحلهای مهندسی در بخش پردازش نقش اساسی داشتهاند. بهعنوانمثال، توسعه منابع نوری i-line، سپس KrF و ArF، شیمیهای پیشرفته مواد حساس به نور و غیره، ازجمله پیشرفتهای عمده در حوزه نیمهرسانا بوده است.
با ادامه روند کاهش فاصله الگوگذاری، مقدار k1 لیتوگرافی (که نشاندهنده سختی فرآیند لیتوگرافی است) کاهش مییابد و درحالحاضر با اسکنرهای 193 نانومتری/1.35NA روبهرو هستیم. زمانیکه مقدار k1 به زیر 0.6 رسید، اسکنرهای موجود به تنهایی قادر به تفکیک تصاویر روی ویفر نبودند، بنابراین نرمافزارهای جدید EDA برای جبران افت رزولوشن توسعه یافت.
نرمافزارهای جدید در ابتدا با تصحیح بهینه مبتنیبر قوانین (OPC) شروع شدند و سپس با پیشرفتهای بعدی شامل OPC مبتنیبر مدل، ویژگیهای کمکپذیر زیر-رزولوشن (SRAF) و سایر تکنیکها همراه شدند. پیشرفتهای فعلی باعث گسترش استفاده از ابزارهای لیتوگرافی شد و ازآنجاکه این تنظیمات پساز مرحله طراحی، در فرایند آمادهسازی ماسک اعمال میشدند، طراح نیاز به دخالت در این مراحل نداشت.
در معماری 20 نانومتری، مقدار k1 به کمتر از 0.25 میرسد و نیاز به فناوری جدیدی به نام دو الگوگذاری (Double Patterning) بهصورت جدی مطرح میشود؛ این روند ادامه یافته و در معماری 14 نانومتری، به سه الگوگذاری یا دو الگوگذاری با کمک جداکننده (SADP) نیاز است. درواقع، حتی باوجود قابلیتهای اولیه اسکنر EUV برای معماری 11 نانومتری، احتمالا هنوز برای برخی لایهها نیاز به استفاده از دو الگوگذاری با EUV باشد.


برخلاف معرفی OPC که نیازی به دخالت طراح نداشت، راهحل دو الگوگذاری (DP) مستلزم اعمال تغییرات جدید در طراحی، تایید فیزیکی و فرآیند رفع اشکال از سوی طراح است. برای بررسی افزایش قابلیتهای وضوح در هر معماری، میتوان گفت که برای لیتوگرافیهای 90، 65 و 28 نانومتری، عمده افزایش رزولوشن از قابلیتهای جدید اسکنرها حاصل شدهاست.
برای لیتوگرافیهای 45 و 20 نانومتری، بیشتر افزایش رزولوشن بهواسطه راهحلهای مبتنیبر نرمافزار امکانپذیر شدهاست. برخی از این نرمافزارها و کارهای اضافی به تدریج وارد فرآیند طراحی شدهاند. روند مهاجرت نیازهای تولید بهسمت طراحی از فعالیتهای پیشنهادی در معماری 65 نانومتری آغاز شد، مانند رعایت قوانین پیشنهادی، بررسیهای لیتوگرافی و تحلیل نواحی بحرانی (CAA). در 45 نانومتر، برخی از شبیهسازیهای لیتوگرافی به الزامات تبدیل شدند.
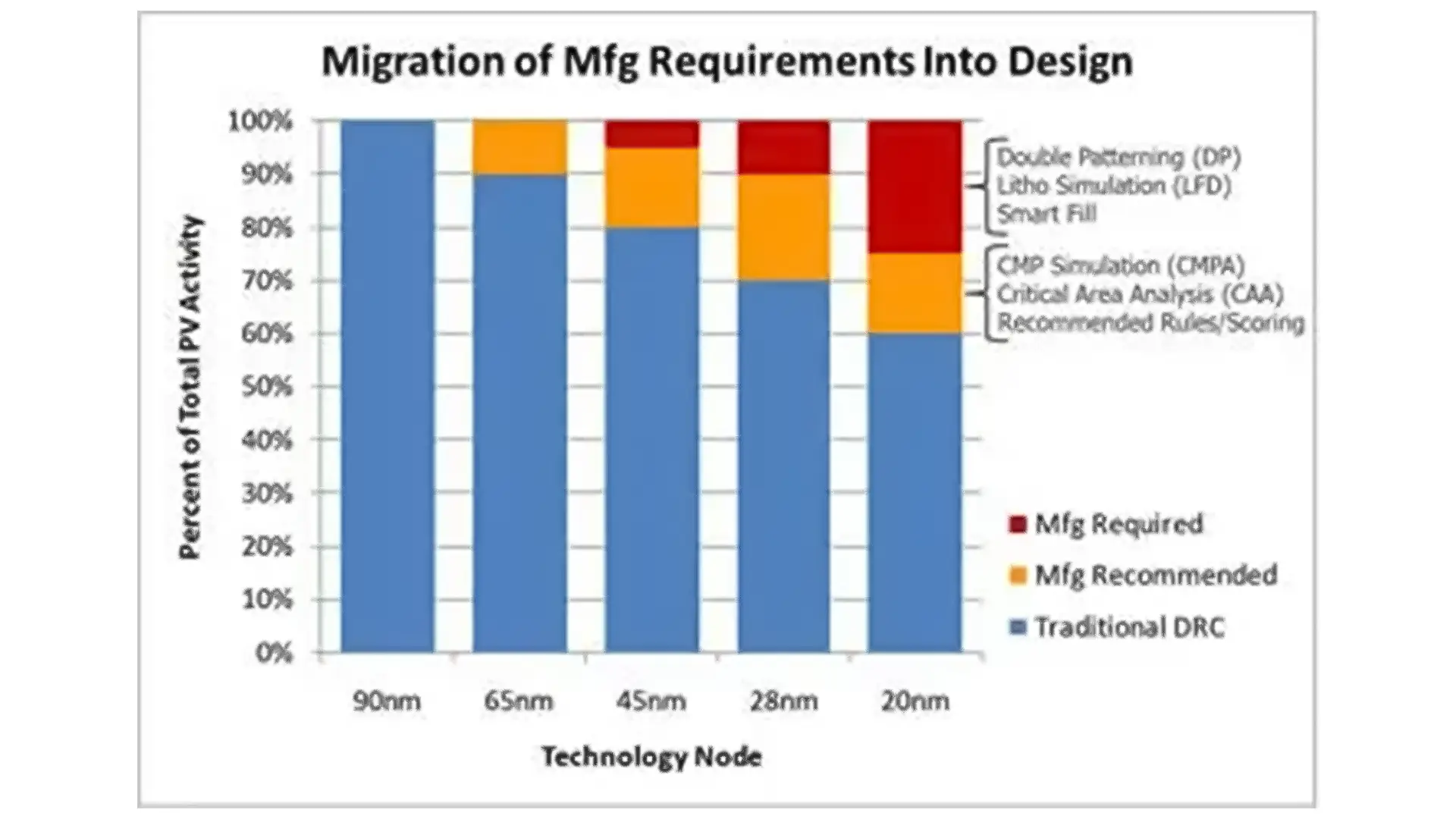
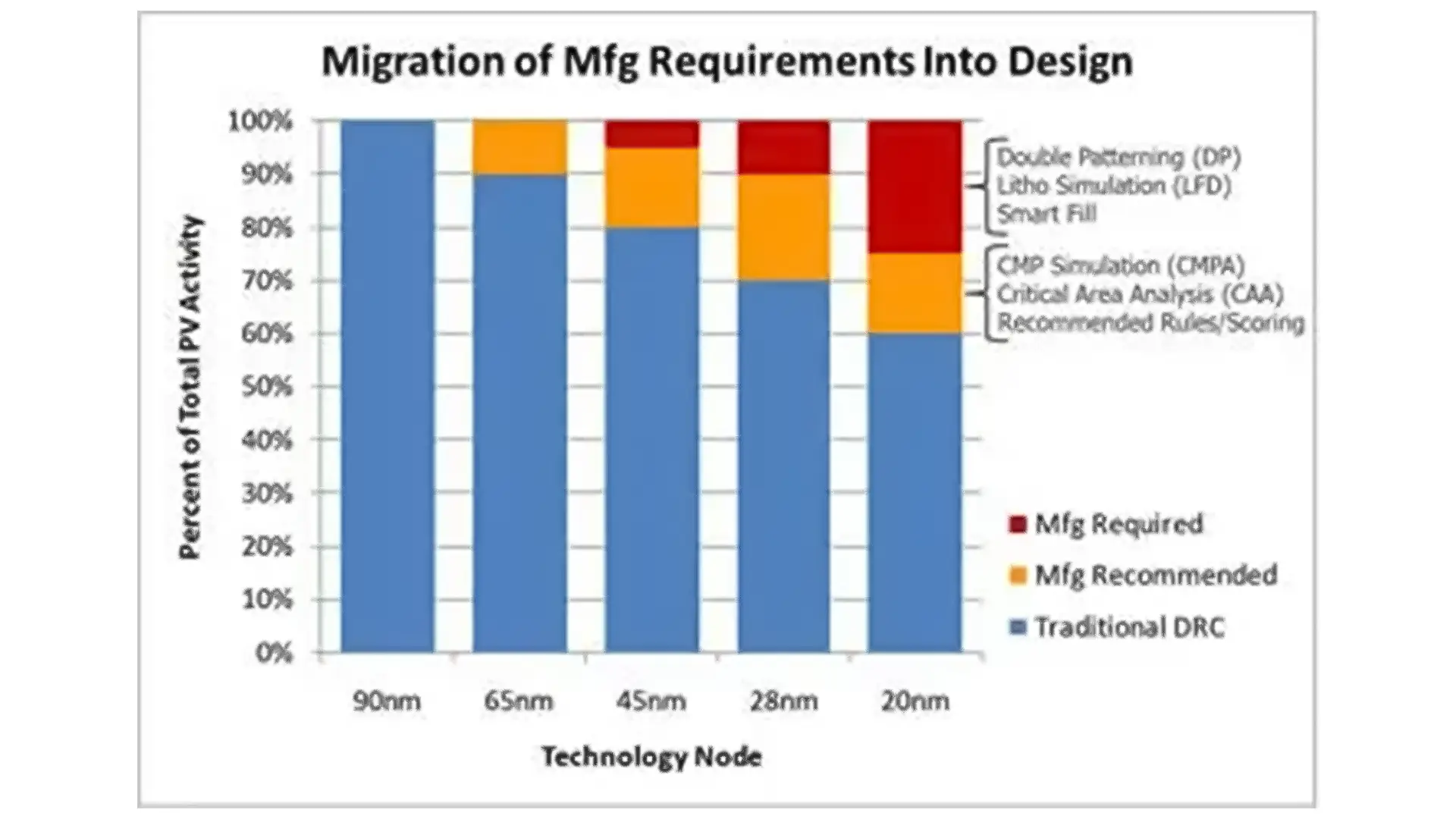
در لیتوگرافی 20 نانومتری، مواردی همچون دو الگوگذاری، شبیهسازی لیتوگرافی و پرکردن هوشمند (Smart Fill) الزامی شد و درعینحال، شبیهسازی CMP، CAA و رعایت قوانین پیشنهادی به شدت توصیه شدند.







